IC后端物理效应WPE--Well Proximity Effect(阱临近效应)
| 阿里云国内75折 回扣 微信号:monov8 |
| 阿里云国际,腾讯云国际,低至75折。AWS 93折 免费开户实名账号 代冲值 优惠多多 微信号:monov8 飞机:@monov6 |
今天介绍一下后端设计中的一些物理效应这些物理效应在以前的老工艺中不太明显但是工艺越先进它们的影响就越大Foundary必须在建库以及后端设计者必须在建版图绘制对于模拟集成电路而言或者布局布线对于数字集成电路而言中考虑这些物理效应否则它们将影响电路的性能甚至可能导致芯片Fail。
这些效应包括
WPE: Well Proximity Effect, 阱临近效应
LOD: Length of Diffusion, 扩散区长度效应
OSE: OD Space Effect, 扩散区/有源区间距效应
PSE: Poly Space Effect, 栅间距效应
WPE: Well Proximity Effect, 阱临近效应
考虑90nm工艺时需要考虑
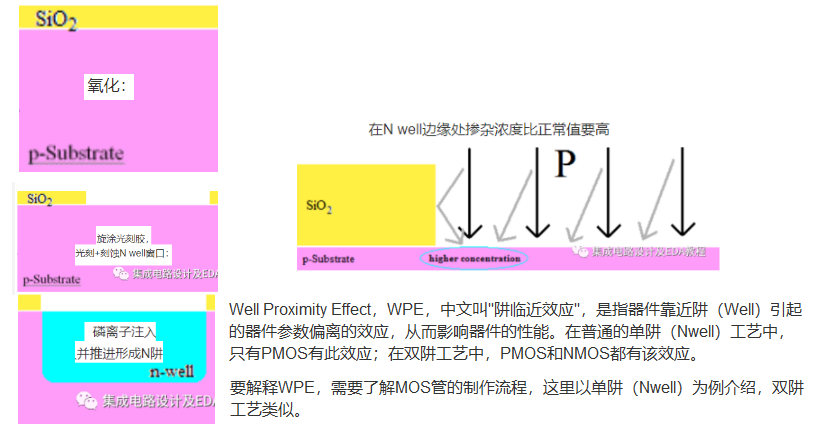

STI stress
考虑0.25um工艺下使用STI浅槽隔离利用CVD沉淀产生SiO2而不是局部氧化LOCOS进行防止SiO2对两侧器件产生应力。
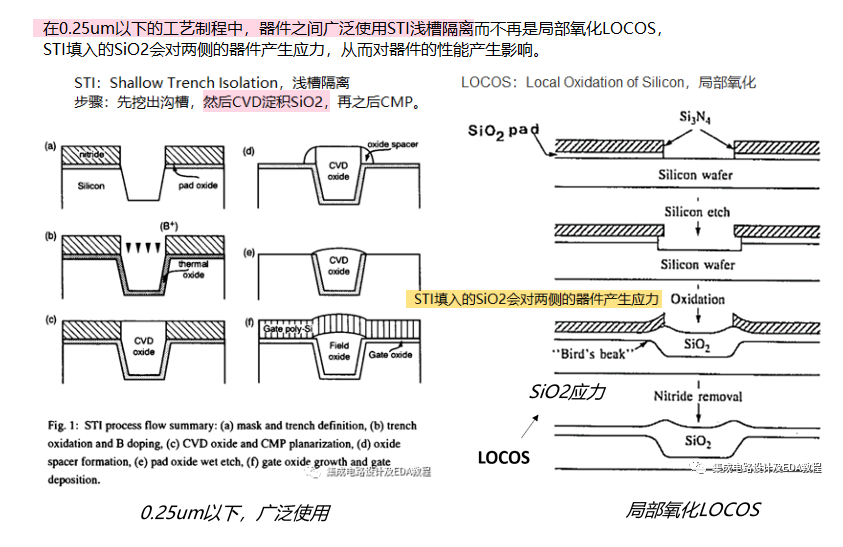
LOD: Length of Diffusion, 扩散区长度效应
考虑在65nm之前的工艺制程中OSE的影响并不明显所以STI stress effect单纯指LOD effect。
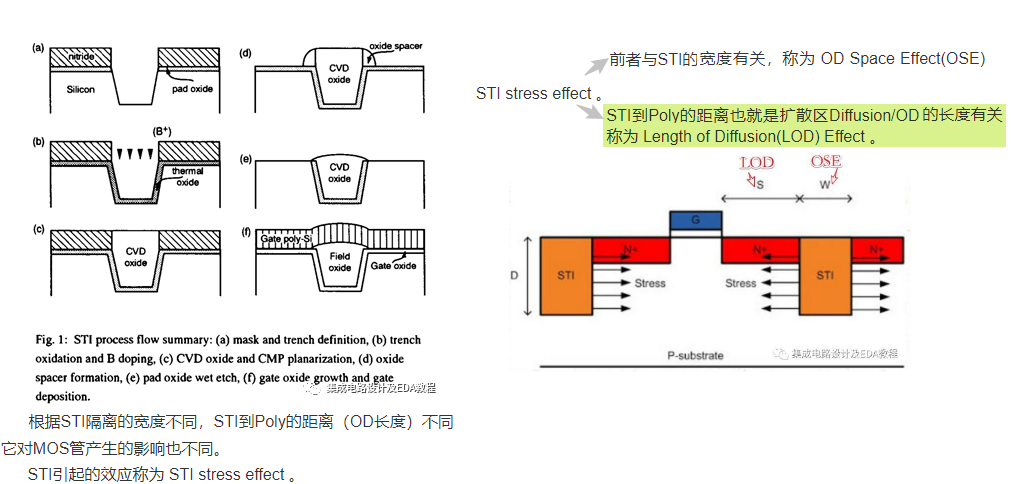
OSE: OD Space Effect, 扩散区/有源区间距效应
考虑在65nm之前的工艺制程中OSE的影响并不明显所以STI stress effect单纯指LOD effect。 而45nm以下的工艺制程OSE的影响就不能再被忽略了。